上海玲荣科技研发中心
KLA - Tencor SP1 DLS (2005 Vintage)
產品特點
Equipment description:
‧Status : Installed and demonstrable
‧Manufacturer : KLA / TENCOR
‧Model : SURFSCAN SP1 DLS
‧Vintage : 2005
‧Equipment Details : Particle measurement system
ADE - 9600
Equipment description:
‧Manufacturer: ADE
‧Model: 9600 UltraScan
‧Type: Wafer Characterization
Version:
‧Condition: excellent
‧Sale condition: as is where is
‧Quantity: 1
晶圓表面輪廓儀 (SANFILTER A999-8)
產品特點
非接觸式形貌量測
高速擷取全域晶圓
微米等級高解析度
3D彩色表面輪廓圖
晶圓膜層應力分析
晶圓形貌缺陷直讀
技術規格
|
晶圓尺寸 |
6吋鏡面晶圓(8, 12吋 option) |
|
橫向解析度 |
< 300 mm (760 × 570 點) |
|
量測重複性 |
< 2 μm (Bow or Warp) |
|
量測時間 |
< 5 sec/片 @ 全域6吋晶圓 |
|
晶圓表面特性 |
拋光、薄膜、研磨、蝕刻 |
|
量測分析參數 |
Bow、Warp、x/y方向剖線圖、3D/立體表面 形貌圖、2D圖、應力、單筆/多筆數據比較 |
|
機台外觀尺寸 |
650(L) x 720(W) x 1760(H) mm |
應用產業
半導體產業高速形貌檢測
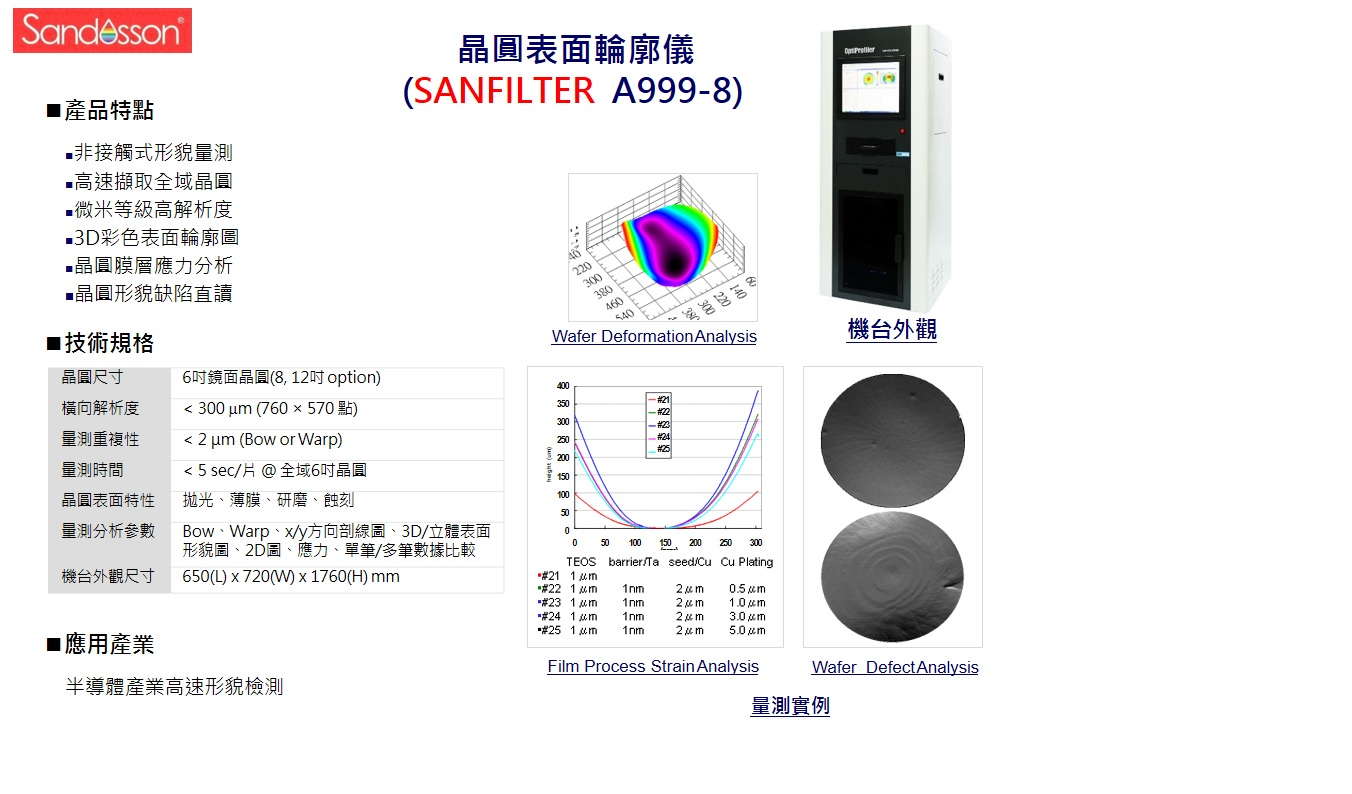
KLA - 5200
產品特點
Equipment description:
‧Purpose: Overlay measurement
‧Model: KLA-Tencor 5200
‧Original Manufacture Date: October, 1997
‧SN: 2100
技術規格
System configuration:
‧Currently Configured for 200mm Wafer Size
‧Handler: 200mm Dual SMIF
‧Cassette Handling: Vacuum Handling Autoloader
‧Robot: Autoloader, Single End-Effector
‧Chuck Type: 200mm Vacuum
‧Operator Interface: Mouse and keyboard standard

晶圓矽孔量測系統(SANTSV/A666-9)
技術規格 Specifications
技術: 單點光譜反射
Technology: Spectral reflection method
量測點大小 : Φ 40 μm (依物鏡倍率)
Spot size : Φ 40 μm (depend on objective)
深寬比 : ³15:1 (@ ϕ5 mm) Aspect Ratio : ³ 15:1 (@ϕ 5 mm)
孔深重複性 : 0.2 mm
Depth Repeatability : 0.2 mm
晶圓尺寸 : 12吋 (R-Θ stage) Wafer size : 12 inch(R-Θ stage)
Vacuum Chuck and color preview camera
可測參數: 孔深, 膜厚, 晶圓厚度, 孔徑尺寸 Measurement parameters: via depth,
dielectric film thickness,
wafer thickness, top critical dimension




